X線光電子分光法(XPS)の原理と応用
1. はじめに
X線光電子分光法は、表面数nmに存在する元素 (Li~U)に対し、定性・定量分析のみならず、材料の特性を決める化学結合状態分析ができる手法として広く普及しています。X線光電子分光法はXPS (X-ray Photoelectron Spectroscopy) の名称だけでなく、ESCA (Electron Spectroscopy for Chemical Analysis) の呼び名で1970年代以降広く知られています。
XPSは励起源として軟X線を用いているため、励起光による試料損傷が少なく、絶縁物の帯電も容易に除去できることから、金属材料だけでなく、高分子材料など多くの材料に対して測定が可能です。
2.原理
XPS はMgKα、AlKαなどの軟X線を物質(A)に照射し、物質(A)のイオン化に伴い放出される光電子e-を補足しエネルギー分析を行う手法です。
A + hν = A+* + e- ......(1)
励起源としてX線を用いる方法がXPSで、一方真空紫外光を用いる方法が真空紫外光電子分光法(UPS: Ultraviolet Photoelectron Spectroscopy)と呼ばれています。
固体表面における光電子放出の模式図を図1に示します。

図1 光電子放出模式図
ま た図2にPTFE(polytetrafluoroethylene)フィルムを分析して得られた光電子スペクトル(ワイドスペクトル)を示します。光電 子は各電子軌道から放出されるため、得られる光電子ピークは図に示すように元素と電子軌道でそれぞれ表記します。図2ではC1s、F1sと表記されていま す。
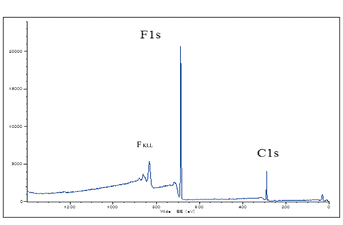
図2 PTFEフィルムの光電子スペクトル(ワイドスペクトル)
図1の光電子放出過程は式(2)で示すことができます。
Ek = hν-φ ......(2)
ここでφは固体の仕事関数(work function)です。電子がフェルミ準位までの準位を全て満たし、照射X線エネルギーが十分に大きいときに放出光電子のエネルギー分布が測定できるならば、式(3)が成り立ちます。
Ek=hν-φ-Eb......(3)
式(3)において、hνは一定、Ekは測定運動エネルギーであるから、φがわかればEb(束 縛エネルギー、または結合エネルギーと呼ばれていますが、ここでは結合エネルギーで表記します)が求められます。固体試料の場合、結合エネルギーはフェル ミ準位を基準として表されます。この基準となるのは、試料とスぺクトロメータのフェルミ準位が平衡しているという仮定に基づいています。この仮定は金属な ど導電性物質に対しては成り立ちますが、絶縁性物質では光電子の放出により、物質表面に過剰の正電荷が溜まります。 この現象は帯電効果(charging effect)と呼ばれ、物質表面に正電荷が溜まることにより、光電子が真空に放出されるときの運動エネルギーが減少します。この帯電効果により見かけ上 結合エネルギーが増加して観測されます。従って、正しい結合エネルギーを得るためには、この見かけの結合エネルギーの増加分を補正しなくてはりません。 帯電効果の防止法としては低速電子線等の照射などがあります。
3.応用
(1)組成分析
光 電子スペクトルでは、横軸に測定電子の原子核に対する結合エネルギー値を、縦軸は放出光電子強度を示します。結合エネルギー値は元素および電子状態などに 依存した値であるため、そのエネルギー値より材料の組成分析ができます。定量値は各ピーク強度の面積強度を算出し、装置固有の感度係数を用いた相対感度因 子法で相対的な評価として求めます。検出限界は平均0.1 atomic %です。注目ピークが他の元素ピークと重なる場合は別軌道ピークを用いるか、または波形分離してピーク強度を求めます。
(2) 化学結合状態分析
あ る元素が他の元素と結合すると、電子状態が変化し、これに対応してXPSのピーク位置も変化します。この変化が化学シフトでXPSの最大の特長の状態分析 を可能としています。図3にPET(polyethylenterephthalate)フィルム表面を測定して得られたC1sスペクトルを示します。図 に示すように波形分離を行い、各ピークのエネルギー値から構成官能基成分を求めることができます。

図3 PETフィルムのC1sスペクトル
(3) 深さ方向分析
数100~数kVに加速したArイオンでスパッタエッチングによる深さ方向分析ができます。図4にSi基板上にSi(25 nm)とSiO2(25 nm)を交互に積層した膜の深さ方向分析例を示します。この方法により、成膜層数や各層の膜厚、構成元素の化学結合状態が明らかになります。
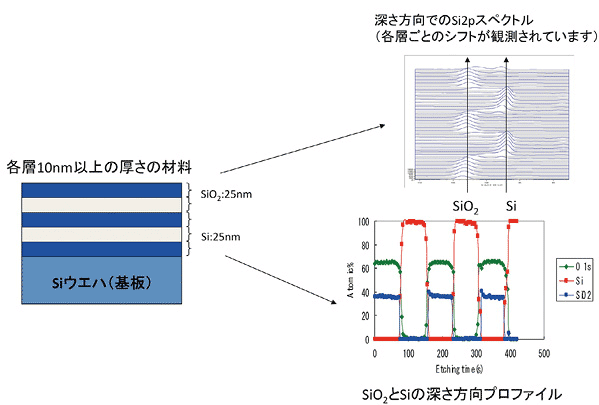
図4 Arイオン照射深さ方向分析例
一方、数nmの厚さの層分析を行う手法として、角度分解XPS法(ARXPS: Angle Resolved XPS)があります。この方法では試料角度θを0°~90°近傍までの任意の角度に設定して、光電子の放出角度を変化させます。図5にARXPSの原理を示します。試料傾斜角度を大きくすると測定深さdがd'になり表面近傍が測定できます。
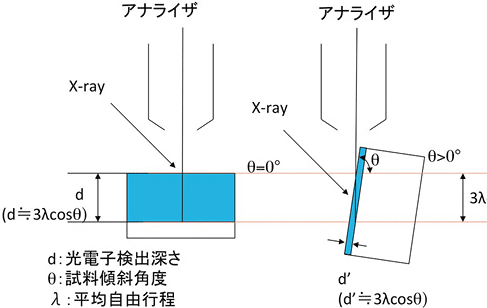
図5 角度分解X線光電子分光法(ARXPS)原理
(4) 元素分布測定
材料表面の不均一性(異物の存在を含む)を調べる方法として、ステージスキャン方式やビームスキャン方式で材料表面の元素分布を測定することが可能です。
(5) 価電子帯スペクトル測定
最外殻軌道(価電子帯)は結晶構造の違いを明確に反映しています。そのため価電子帯の測定から結晶構造の類推が可能となります。図6にTiO2のアナターゼ構造(左)とルチル構造(右)の価電子帯スペクトルを示します。両者のスペクトルに差異が見出され、構造の違いが示唆されています。
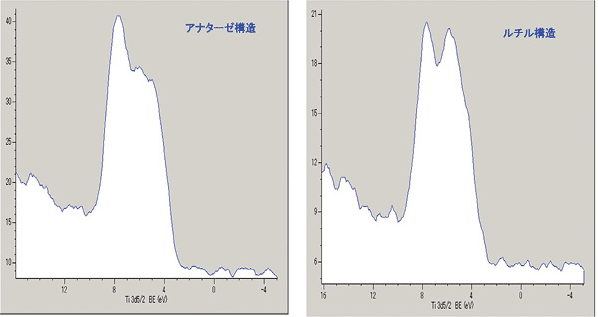
図6 TiO2の価電子帯スペクトル
4.まとめ
XPSは 材料分野で広く応用されており、材料開発において必要不可欠な表面分析法となっています。しかし、XPSは(i)検出感度が数100 ppmと低い、(ii)X 線励起のため分析領域が電子線使用の装置に比べ大きい、などの問題があります。これらの問題を解決するため、最近では、より高感度測定(検出限界向上)を 可能とした測定方法、全反射 XPS法(TRXPS: Total Reflection XPS)など新技術が開発されています。特に、X線を単色化する際のモノクロメータの精度向上などにより数10μm径以下の微小部測定を可能とする機器の普及だけでなく、励起光源として硬X線源(例えばAgLα線 など)を用いて、数10 nmの深さからの光電子を得る硬X線光電子分光法(HAXPES: Hard X-ray Photoemission Spectroscopy)も注目されるようになってきています。今後より分析対象材料に適した手法の開発が期待されています。
新村典康
(日本電子株式会社)
2016年7月26日 公開












